重庆静态测试真空封盖自动线
IGBT模块的生产过程涉及多个阶段。在真空回流焊接过程中,芯片与铜直接键合(DBC)由于工艺限制,基板上铜层之间的焊料层和DBC下铜层与模块底板之间的焊料层会出现空洞。焊接层的空洞缺陷也会出现在贴片工艺步骤中。由于材料的热膨胀系数,IGBT模块在使用过程中空洞不稳定(CTE,热膨胀系数)的不匹配会产生热应力,从而进一步扩大工作过程中模块温度的变化。甚至导致相邻的空洞连接成一块,促进焊接层分层,导致模块功能故障。空洞的原因有很多,极大地影响了模块的热性能,增加了模块的热阻,降低了散热性能,增加了设备的局部温度,甚至进一步降低了模块的可靠性和使用寿命。IGBT可以用于现场可控硅(FACTS),用于调整电力系统的频率、电压和功率。重庆静态测试真空封盖自动线

wafer阶段测试。目前wafer阶段测试,大部分晶圆厂或封装厂采用的都是静态测试。但是静态测试的条件比较有限,IGBT只能在低电压大电流或者高电压小电流的条件下工作,对芯片的筛选能力有限。而动态测试条件下,IGBT要在高电压和大电流下开通和关断,对其性能要求更加严苛,筛选标准更严格,若再配合高温短路测试,则筛选能力大幅提高。但是针对wafer的动态测试技术难度很高,实现起来非常困难,且测试设备极其昂贵,也不容易买到。所以wafer阶段的动态参数测试,现阶段不容易实现。湖南真空封盖自动线行价IGBT的工作原理是将电路的电流控制分为两个部分:绝缘栅极的电流控制和双极型晶体管的电流控制。

下面是一张IGBT实物图,可以看出主要的物料有IGBT芯片,二极管,五金件,键合丝,陶瓷基板,外壳等。IGBT模块生产工艺流程如下所示:IGBT模块工艺流程简介:(1)贴晶圆:使用晶圆贴片机将切合的IGBT晶圆和锡片贴装到DBC基板上;IGBT晶圆,上面被分割成一颗颗的正是IGBT芯片。贴片设备会将晶圆上的IGBT芯片自动取下来,放置到固定的衬板上,形成IGBT模块的电路;(2)真空回流焊(一次):根据客户需求,将贴好晶圆的DBC基板送入回流炉中,在炉内进行加热熔化(一次回流炉使用电加热,工作温度245℃,持续工作7分钟左右), 以气态的甲酸与锡片金属表面的氧化物生成甲酸金属盐,并在高温下裂解还原金属,以此达到焊接目的,需向炉内注入氮气作为保护气以保证焊接质量。甲酸焊接过程化学反应机理如下:HCOOH+MO→M+H2O+CO2。
焊接IGBT功率模块封装失效,一般采用Al或Cu键合线将端子与芯片电极超声键合,实现与外部电气的连接。这两种材料都与Si和Si上的绝缘材料有很大的不同,如SiO2的CTE。模块工作时,IGBT芯片功耗和键合线焦耳热会提高键合线温度,在接触点和键合线上产生温度梯度,形成剪切应力。长期处于开关循环工作状态,产生应力和疲劳形变积累,会导致接触点裂纹、接触热阻增大、焦耳热增大、温度梯度增大,较终导致键合线损坏加剧,形成正反馈循环,较终导致键合线脱落或断裂。研究表明,这些故障是由材料CTE不匹配引起的。键合线断裂的位置出现在其根部,这是键合线故障的主要表现。一些研究指出,可以通过优化键合线的形状来提高其可靠性。具体来说,键合线的高度越高,键合线的距离越远,键合线的应力水平越低,可靠性越高。什么是IGBT,功率半导体是半导体行业的细分领域,虽不像集成电路一样被大众熟知,但其重要性不可忽视。
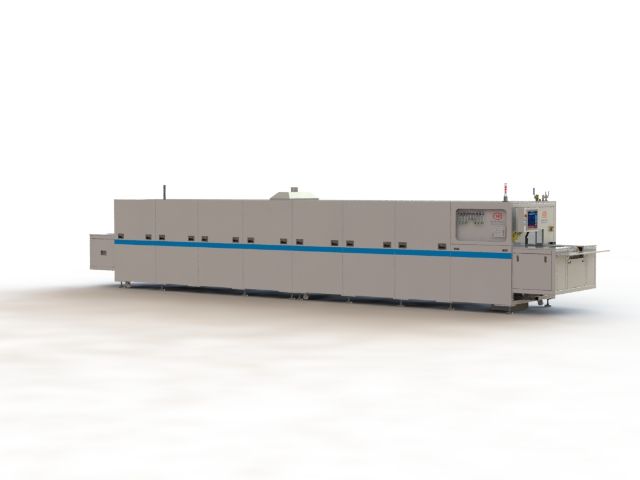
在加热压力的同时,导线的表面绝缘层也会气化。电阻热能保证先剥离导线的涂层,再依靠端子的夹紧力保证结合强度,可以节省剥离导线绝缘层的过程,节省一些时间,提高效率,减少劳动力。电机定子引出线热熔焊机已经被越来越多的厂家使用,尤其是一些新能源汽车驱动电机厂商。我们自主研发的焊接监控系统已被西门子法雷奥、中车时代、巨一等有名新能源汽车电机厂商采用,得到了他们的一致认可。由于我们的设备配备了位移监控,端子的焊接稳定性和一致性较大程度上提高。这种直接熔接的方式,很容易让人担心,这样脱漆干净吗?多条漆包线大平方的电机引出线能否达到良好的导通性?拉力能满足要求吗?这些问题可以放心!经过长时间的反复试验,我公司电机定子引出线焊接热熔焊机可实现99.9%的熔融产品优良率。IGBT有着紧凑的结构,体积小,可以降低整个系统的体积,有利于系统的自动化程度的提高。广西高精度DBC底板贴装机
随着IGBT模块的自主可控、国产化进程加速,国产测试系统产品需求也逐渐迫切。重庆静态测试真空封盖自动线
IGBT模块的生产流程?可以看到IGBT模块横切面的界面,目前壳封工艺的模块基本结构都相差不大。IGBT模块封装的流程大致如下:贴片→真空回流焊接→超声波清洗→X-ray缺陷检测→引线键合→静态测试→二次焊接→壳体灌胶与固化→端子成形→功能测试(动态测试、绝缘测试、反偏测试),贴片,首先将IGBT wafer上的每一个die贴片到DBC上。DBC是覆铜陶瓷基板,中间是陶瓷,双面覆铜,DBC类似PCB起到导电和电气隔离等作用,常用的陶瓷绝缘材料为氧化铝(Al2O3)和氮化铝(AlN);真空焊接,贴片后通过真空焊接将die与DBC固定,一般焊料是锡片或锡膏;X-ray空洞检测,需要检测在敢接过程中出现的气泡情况,即空洞,空洞的存在将会严重影响器件的热阻和散热效率,以致出现过温、烧坏、爆裂等问题。一般汽车IGBT模块要求空洞率低于1%;接下来是wire bonding工艺,用金属线将die和DBC键合,使用较多的是铝线,其他常用的包括铜线、铜带、铝带;中间会有一系列的外观检测、静态测试,过程中有问题的模块直接报废;重复以上工序将DBC焊接和键合到铜底板上,然后是灌胶、封壳、激光打码等工序;出厂前会做然后的功能测试,包括电气性能的动态测试、绝缘测试、反偏测试等等。重庆静态测试真空封盖自动线
上一篇: 黑龙江一体化外壳组装兼容设备
下一篇: 陕西高精度真空封盖自动线